JA
日本語 (JA)
TCBは、パッケージされた内部の構造物と電気配線の封止を1工程で行うことができます。TCBで最も使用される材料は、拡散反応が速いAu、Al、Cuなどです。AuはAlやCuに比べて拡散に必要な温度が低く、酸化されにくいという利点があります。拡散速度は、原子が結晶格子間に拡散する際に選択された温度と印加圧力に依存します。ここで、標準的な表面拡散に加えて、粒界拡散とバルク拡散が発生します。
この技術では、電界をかけずに低温でウェーハレベルの接合を実現します。その上で、接合時の応力やアライメントのズレを防ぐために、CTE(熱膨張係数)を適切に制御し、ウェーハの膨張を同期させることが重要です。さらに、加える力とその均一性も重要となり、これは金属の密度(特徴)やウェーハのサイズにも依存します。TCBでは、接合温度と印加圧力が反比例するので、これによって、接合パラメータを調整することが可能となります。
特長
- 導電性
- 高い破壊靭性
- 小型ボンディングフレーム
- 密封性
- 非常に高い接合アライメント精度
- 汚染フリー
- 非変形
数値
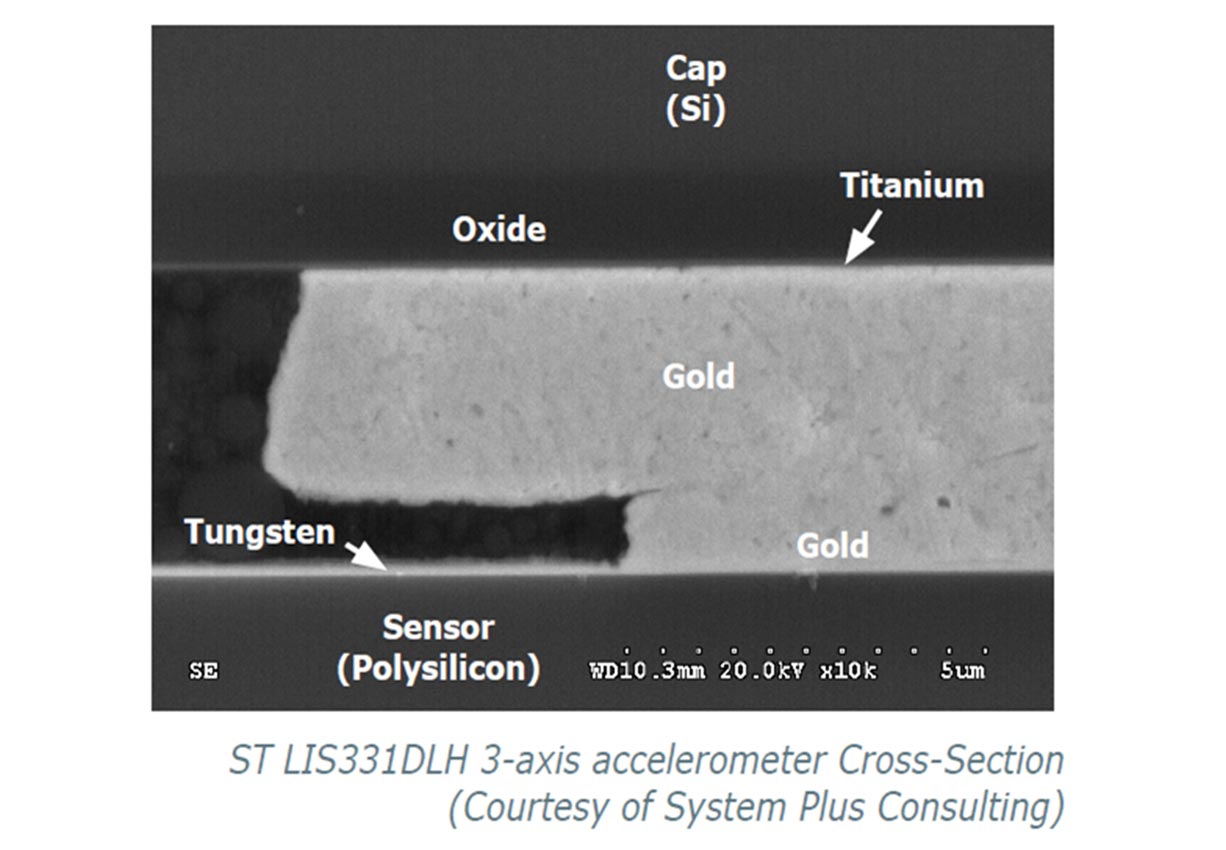
TCBで接合された3軸加速度計のSEM断面画像

TCB(Cu-Cu)でウェーハ集積接合された3次元シリコン垂直配線の断面イメージ図
Events

CS MANTECH 2024
Visit our booth #406!
20.05. - 23.05.2024
Tucson, USA

ECTC 2024
Visit our booth #552 and our talk "Ultra–High Density RDL Patterning of High–Resolution Dielectrics by Maskless Exposure Technology for High Performance Computing and Artificial Intelligence Devices" held by Dr. Varga Ksenija!
28.05. - 31.05.2024
Denver, USA

Semicon South East Asia 2024
Visit our booth #1223!
28.05. - 30.05.2024
Kuala Lumpur, Malaysia

Talk to our EVG technology experts!
Questions?
Questions about our technologies?
Contact the EVG experts